Site-Specific Synthesis of 2D TMDs for High-Performance Nanoelectronic Devices
A lithographically defined, transfer-free CVD process enables site-specific growth of MoS₂ directly on CMOS-compatible SiO₂/Si substrates using patterned MoO₃ as both precursor and high-k dielectric. The approach delivers tunable crystallinity, improved interface quality, and enhanced FET performance while eliminating post-growth transfer and etching steps.
Two-dimensional transition metal dichalcogenides (TMDs) such as MoS₂ are promising channel materials for next-generation nanoelectronics, optoelectronics, and sensing platforms. Conventional synthesis methods rely on CVD growth on foreign substrates such as sapphire or gold, followed by mechanical transfer onto SiO₂/Si. These transfer steps introduce cracks, wrinkles, contamination, and interfacial traps that degrade device performance and limit CMOS compatibility. Existing selective-area growth methods often require complex substrate templating, metal seed layers, or post-growth lithography and etching, which increase process complexity and reduce material quality. A scalable, transfer-free, CMOS-compatible approach to site-specific 2D material growth remains a critical need.
This University at Buffalo technology introduces a lithographically defined, transfer-free CVD strategy for site-specific synthesis of MoS₂ directly on SiO₂/Si substrates. Patterned MoO₃ thin films serve as multifunctional precursors and dielectric layers. During sulfurization, MoO₃ is selectively converted into MoS₂ only in predefined regions, eliminating the need for post-growth patterning.
Thermal annealing enables phase control of MoO₃, including formation of orthorhombic α-MoO₃ with a high dielectric constant (~35), allowing in-situ integration of a native high-k gate dielectric beneath the MoS₂ channel. By tuning sulfurization temperature, duration, and sulfur flux, the process yields either single-crystalline domains for high-performance logic devices or isotropic polycrystalline films for large-area applications. The resulting MoS₂/MoO₃/SiO₂ stack exhibits reduced interfacial trap densities, improved carrier transport, and enhanced metal-semiconductor contact properties.
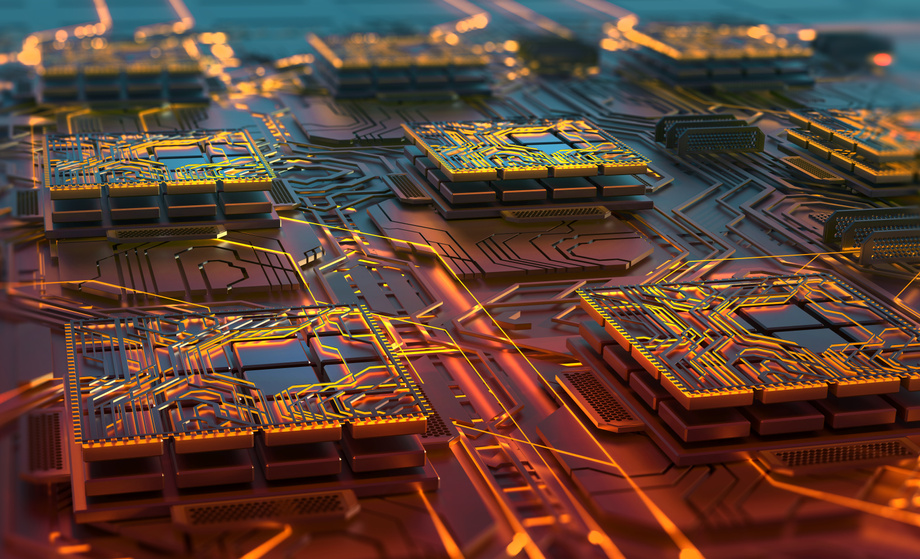 Source: Siarhei, https://stock.adobe.com/uk/360512492, stock.adobe.com
Source: Siarhei, https://stock.adobe.com/uk/360512492, stock.adobe.com
- Transfer-free, wafer-scale growth directly on CMOS-compatible SiO₂/Si substrates
- Precise spatial control via lithographic precursor patterning without post-growth etching
- Multifunctional MoO₃ layer serving as both growth precursor and high-k dielectric (~35)
- Tunable crystallinity and grain structure through controlled sulfurization
- Reduced interfacial trap density and improved subthreshold swing
- Lower Schottky barrier height and contact resistance through interface engineering
- CMOS process compatibility and scalability for high-throughput manufacturing
- Demonstrated field-effect mobility ~20 cm²/V·s with enhanced ON-current and on/off ratios
- Ultra-scaled, low-power field-effect transistors (FETs) for next-generation logic circuits
- Non-volatile memory, memristors, and neuromorphic computing elements
- RF and analog 2D transistor devices
- Integrated photodetectors, photosensors, LEDs, and photovoltaic layers
- Chemical and biosensors based on high-quality MoS₂ FET channels
- Pre-patterned 2D growth wafers and CVD process modules for semiconductor foundries
- Integration platforms for additional TMD materials including WS₂, MoSe₂, WSe₂, MoTe₂, and heterostructures
Provisional application 63/968,556 filed on 1/26/2026
Laboratory-scale synthesis demonstrated with fabricated MoS₂ FET devices showing improved electrical performance metrics.
TRL 4–5
Available for licensing and industry collaboration.
Patent Information:
| App Type |
Country |
Serial No. |
Patent No. |
Patent Status |
File Date |
Issued Date |
Expire Date |
|